Scientific journal
Modern problems of science and education
ISSN 2070-7428
"Перечень" ВАК
ИФ РИНЦ = 0,936
SIMULATION OF IONIZATION LOSSES IN STTL LOGIC ELEMENTS
Для повышения оперативности разработки изделий электронной техники и оценки их стойкости к проникающей радиации применяют моделирование процессов взаимодействия заряженных частиц с кристаллами интегральных структур. С помощью компьютерного моделирования можно определить ионизационные потери энергии при взаимодействии одиночных заряженных частиц с кристаллом микросхемы [2-4].
В работе моделирование взаимодействия протонов и ионов железа в диапазоне энергий 1–100 МэВ со структурами кристалла логической микросхемы, выполненной по технологии транзисторно-транзисторной логики с диодами Шоттки (ТТЛШ) (рис. 1), проведено с применением версии SRIM 2013 компьютерной программы TRIM [5].
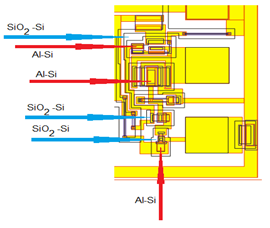 а)
а) 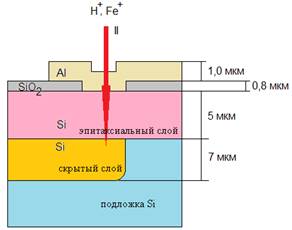 б)
б)
Рис. 1. Фрагмент топологии кристалла (стрелками показаны области со структурами SiO2-Si и Al-Si) и схематическое изображение исследуемых структур
Время нарастания тока определяется временем прохождения иона вдоль трека. Скорость движения протона и иона железа в структуре определяли с учетом их первоначальной энергии, затем вычисляли максимальный ток, возникающий в структуре микросхемы при прохождении ионизирующей частицы.
Исследовались две типовые структуры, представленные на рисунке 1:
1) структура, состоящая из слоя металлизации (Al), эпитаксиальной пленки и скрытого слоя кристалла микросхемы, имитирующая попадание частицы в область контакта (рис. 1, а);
2) структура, состоящая из слоя диоксида кремния, эпитаксиальной пленки и скрытого слоя кристалла микросхемы, имитирующая попадание частицы в активную область элемента микросхемы вне области контакта, занятой металлизацией (рис. 1, б).
На рисунке 2 представлены треки, ионизационные потери энергии и трехмерный профиль распределения потерь энергии на ионизацию для протонов с энергией 1 и 100 МэВ в структуре SiO2–Si. Аналогичные зависимости для ионов железа с энергией 30 и 100 МэВ при взаимодействии со структурой Al–Si представлены на рисунке 3.
Расчеты показывают, что характер взаимодействия протонов с двумя типами структур практически идентичен, и основной вид потерь энергии частицы приходится на ионизацию. Выделение энергии при бомбардировке структур протонами с энергией 1 МэВ происходит в основном в эпитаксиальной пленке и скрытом слое структуры с максимумом распределения вблизи нижней границы скрытого слоя (средний пробег протона в структуре около 14,5 мкм). Для протонов с энергиями 30 МэВ и 100 МэВ пробег значительно превышает толщину рассматриваемой области, и ионизационные потери энергии распределяются практически равномерно по всей толщине эпитаксиальной пленки и скрытому слою.
Вследствие большой атомной массы иона Fe+ поглощение ионов происходит в объеме эпитаксиальной пленки и скрытого слоя структуры, причем для ионов Fe+ с энергией 1 МэВ потери энергии наблюдаются либо непосредственно в слое Al, либо вблизи границы раздела SiO2–Si. При взаимодействии ионов железа с энергиями 30 МэВ и 100 МэВ потери энергии на ионизацию значительны. Это обстоятельство может быть решающим фактором в возникновении сбоев при функционировании интегральной микросхемы. Расчеты показывают, что 99,9 % потерь энергии ионов приходится на ионизацию в слоях структуры для рассмотренных случаев.
|
|
|
|
|
а1 |
б1 |
в1 |
|
|
|
|
|
а2 |
б2 |
в2 |
Рис. 2. Треки (а), ионизационные потери частиц (б) и трехмерный профиль ионизационных потерь энергии (в) для протонов в структуре SiO2–Si для энергий 1 МэВ (1) и 100 МэВ (2)
По результатам моделирования процессов взаимодействия ионов с исследуемыми структурами можно вычислить число электронно-дырочных пар, которые образуются в активной области элементов кристалла микросхемы [1], и, следовательно, можно оценить величину суммарного избыточного заряда, поступающего в активную область транзисторов.
Определено, что наиболее критичные режимы, которые возникают при взаимодействии одиночных частиц, соответствуют бомбардировке протона с энергией 1 МэВ и иону железа с энергией 100 МэВ. Поэтому в дальнейших расчетах определялись параметры импульсов тока, соответствующих этим режимам.
|
|
|
|
|
а1 |
б1 |
в1 |
|
|
|
|
|
а2 |
б2 |
в2 |
Рис. 3.Треки (а), ионизационные потери частиц (б) и трехмерный профиль ионизационных потерь энергии (в) для ионов железа в структуре Al –Si для энергий 30 МэВ(1) и 100 МэВ (2)
Из результатов расчетов скорости частиц и времени нарастания импульса тока (табл. 1) видно, что ионизация области глубиной 12–15 мкм от поверхности кристалла наиболее критична при взаимодействии ионизирующей частицы с кристаллом. Электрическая схема логического элемента для моделирования в программе Micro-Cap 9.0.6.1 представлена на рисунке 4.
Таблица 1
Скорость движения частиц в структуре кристалла и время нарастания импульса тока
|
Тип иона |
Энергия иона, МэВ |
Скорость движения иона, м/с |
Время нарастания импульса тока, с |
Максимальное значение импульса тока, А |
|
Н+ |
1 |
1,4 107 |
1,08 10-12 |
0,029 |
|
Н+ |
30 |
7,6 107 |
1,98 10-13 |
0,042 |
|
Н+ |
100 |
1,4 108 |
1,08 10-13 |
3,15 |
|
Fe+ |
1 |
1,85 106 |
3,24 10-13 |
0,09 |
|
Fe+ |
30 |
1,01 107 |
8,2 10-13 |
8,1 |
|
Fe+ |
100 |
1,9 107 |
8,1 10-13 |
19,8 |
В процессе моделирования входной сигнал в виде меандра подавался от источника напряжения V2. Источник питания V1 — напряжение величиной 5,5 В. Резистор R5 выполняет функцию нагрузки логического элемента.

Рис. 4. Электрическая схема логического элемента
Осциллограммы входного и выходного сигналов в процессе моделирования электрической схемы логического элемента без воздействия ионизирующих частиц типичны для работы биполярного логического элемента. Уровни выходного сигнала соответствовали уровням ТТЛШ логики и сбоев в функционировании элемента не наблюдается.
Результаты моделирования показали, что для всех типов ионов в исследованном диапазоне энергий попадание частицы в карманы кристалла, содержащего резисторы, сбоя в работе микросхемы не вызывают.
При попадании ионизирующей частицы в коллекторные области транзисторов или в области диодов Шоттки сбой (рис. 5) в работе логического элемента наблюдается в случае превышения суммарного ионизационного тока величины 50 мА, что соответствует воздействию одиночного протона с энергией 30 МэВ. Воздействие низкоэнергетичных частиц сбоя в работе микросхемы не вызывает.
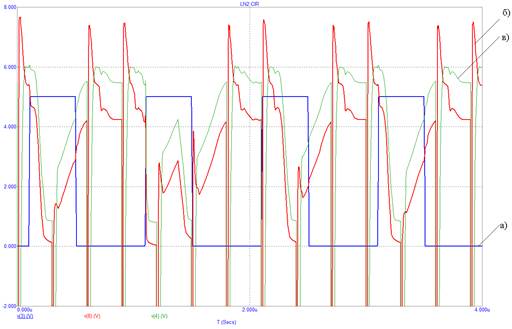
Рис. 5. Сбой в работе логического элемента микросхемы при попадании протона с энергией 100 МэВ в коллекторную область транзистора: а) – входной сигнал; б) – выходной сигнал; в) – напряжение на коллекторе Т2
Влияние корпуса микросхемы на характер взаимодействия заряженных частиц с кристаллом ИС учитывают путем добавления в структуру слоя никеля толщиной 200 мкм, имитирующего крышку металлокерамического корпуса микросхемы.
Моделирование процесса взаимодействия заряженных частиц со структурой, включающей корпус микросхемы, показало, что ионы с атомной массой больше протона и энергией менее 100 МэВ полностью поглощаются крышкой корпуса микросхемы.
Рецензенты:
Саркаров Т.Э., д.т.н., профессор каф. теоретической и общей электротехники ФГБОУ ВПО «Дагестанский государственный технический университет», г. Махачкала;
Мелехин В.Б., д.т.н., профессор, зав. каф. вычислительной техники ФГБОУ ВПО «Дагестанский государственный технический университет», г. Махачкала.
Библиографическая ссылка
Мустафаев Г.А., Панченко В.А., Мустафаев А.Г., Панченко Д.В., Черкесова Н.В. МОДЕЛИРОВАНИЕ ИОНИЗАЦИОННЫХ ПОТЕРЬ ТТЛШ ЛОГИЧЕСКОГО ЭЛЕМЕНТА // Современные проблемы науки и образования. 2015. № 1-1. ;URL: https://science-education.ru/en/article/view?id=19357 (дата обращения: 02.05.2026).